Herstellung eines MOSFET
Einleitung
In diesem Artikel geht es um die Herstellung eines MOSFETs. Dabei lernt man zudem den Aufbau eines MOSFETs nochmals detaillierter kennen. In folgendem Artikel wurde bereits Grundlegend aber vereinfacht der Aufbau eines MOSFETs dargestellt:
⇨ MOSFET Aufbau
Wie dort bereits erklärt unterscheiden sich die verschiedenen MOSFET Arten im Aufbau. Deshalb wird in diesem Artikel die Herstellung am beispiel eines N-Kanal MOSFETs gezeigt.
⇨ MOSFET Arten
Eine Allgemeine Erklärung zum MOSFET findet sich im unten stehenden Link.
⇨ Allgemeine Erklärung
Schritt 1
Die Grundlage eines MOSFET bildet das sogenannte Substrat. Mit diesem fängt die Herstellung an. Für einen N-Kanal MOSFET wird hierzu ein P-Dotierter Halbleiter verwendet. Typischerweise wird als Halbleiter Silizium verwendet und zur Dotierung wird Bor verwendet.

Schritt 2
Mithilfe einer sogenannten Trockenoxidation wird auf dem Substrat Siliciumdioxid (SiO2) erzeugt.
Später dient das Siliciumdioxid der Isolation zwischen Gate und dem Substrat. (später dazu mehr)

Schritt 3
Mit einem sogenannten LPCVD-Prozess wird das sogenannte Nitrid abgeschieden. Im späteren Verlauf der Herstellung wird das Nitrid als Maskierung bei der Feldoxidation dienen.

Schritt 4
Im vierten Schritt wird auf das Nitrid ein Fotolack aufgebracht. Darauf folgt die Belichtung und Entwicklung des Lacks. Dadurch entsteht eine strukturierte Lackschicht auf dem Nitrid.
Später dient diese Lackschicht als Ätzmaske.
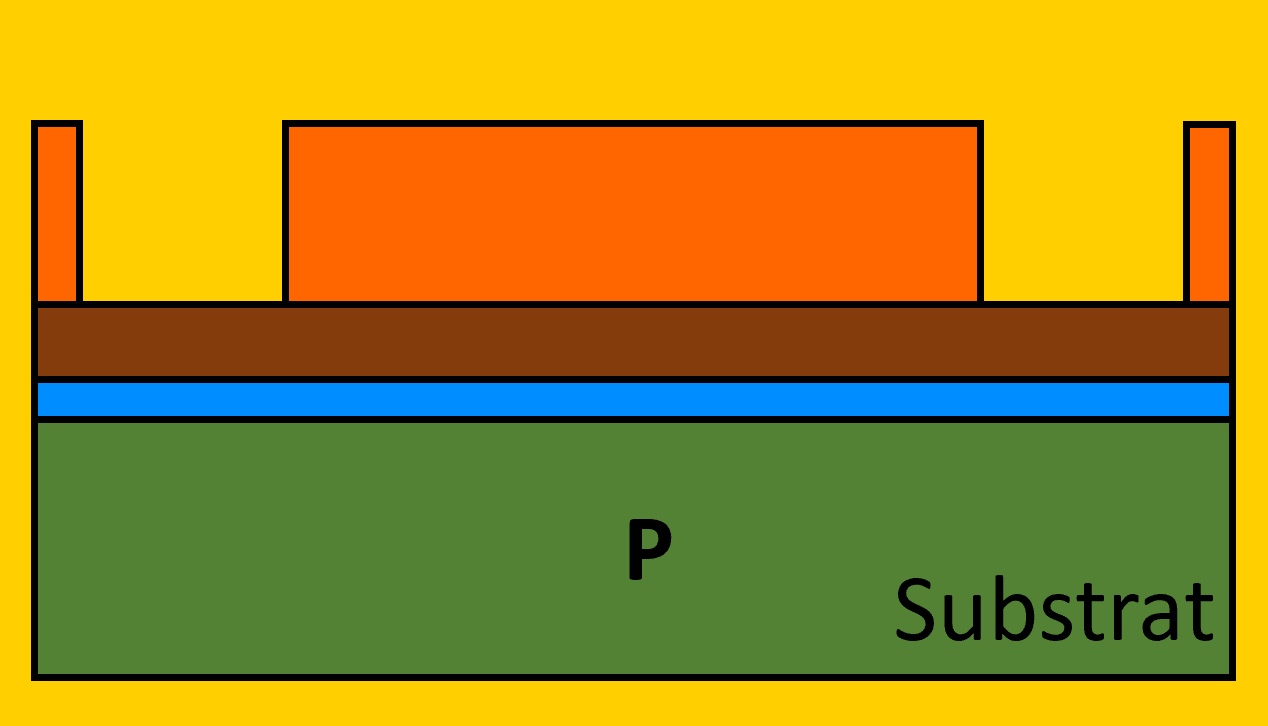
Schritt 5
Nachdem die Ätzmaske in Form von Lack aufgebracht wurde, folgt das Ätzen.
Im Praktischen bedeutet das, dass alles weggeätzt wird was nicht von Lack bedeckt ist.
Somit wird das Nitrid sauber an den gewünschten Stellen geätzt, wie es unten im Bild gezeigt ist.
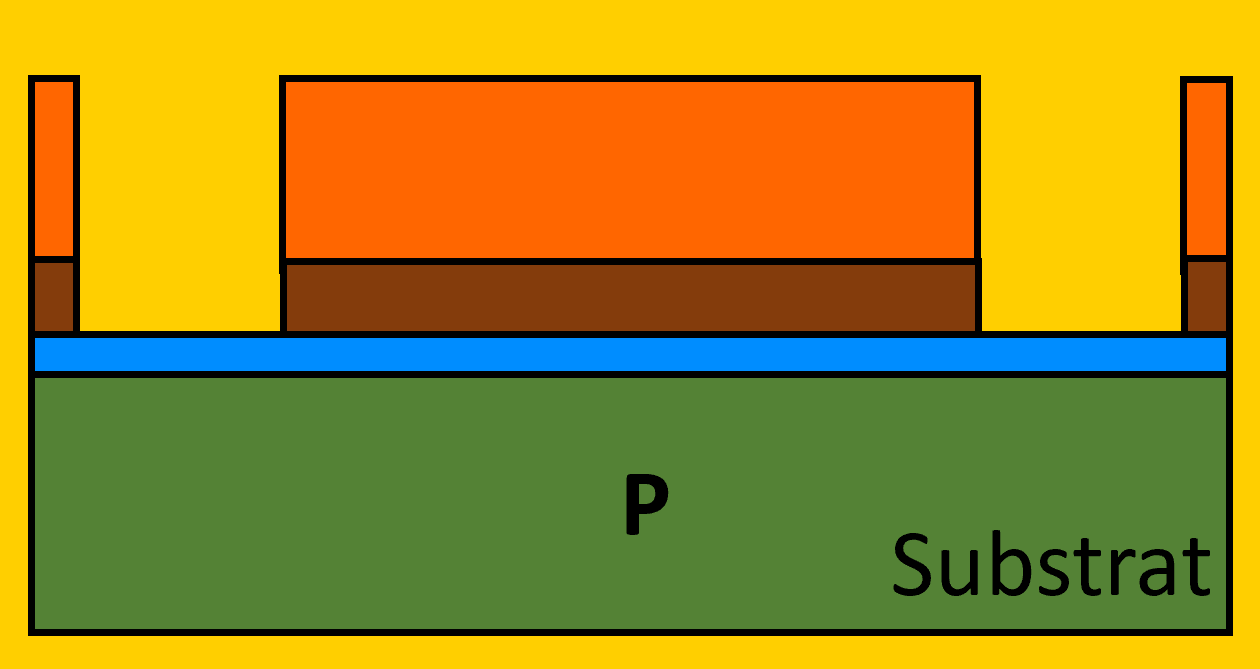
Schritt 6
Nun ist das Nitrid an den gewünschten Stellen geätzt. Daher wird nun der Lack wieder entfernt. Dies geschieht nasschemisch mithilfe einer Entwicklerlösung.

Schritt 7
Nun dient wiederum das Nitrid als Maske.
Bei den Flächen welche kein Nitrid besitzen findet eine thermische Nassoxidation statt.
Ziel dieses Vorgehens ist es die Isolation auch seitlich zu gewährleisten um benachbarten Bauteile zu schützen.

Schritt 8
Das Nitrid hat nun seine Aufgabe als Oxidations-Maske vollbracht und wird deshalb entfernt. Dies geschieht mit einem nasschemischen Ätzprozess.

Schritt 9
Mithilfe eines LPCVD-Prozesses wird polykristallines Silizium abgeschieden. Dies bildet eine weitere Schicht.

Schritt 10
Auf dieses sogenannte Polysilizium wird eine Lackschicht aufgebracht. Diese dient, wie zuvor auch, als Maske für das spätere Ätzen.

Schritt 11
Nachdem die Ätzmaske in Form von Lack aufgebracht wurde, folgt das Ätzen.
Im Praktischen bedeutet das, dass alles weggeätzt wird was nicht von Lack bedeckt ist.
Somit wird das Nitrid Polysilizium an den gewünschten Stellen geätzt, wie es unten im Bild gezeigt ist.
Übrig bleibt die sogenannte Gateelektrode welche zur Steuerung des Transistors dient.
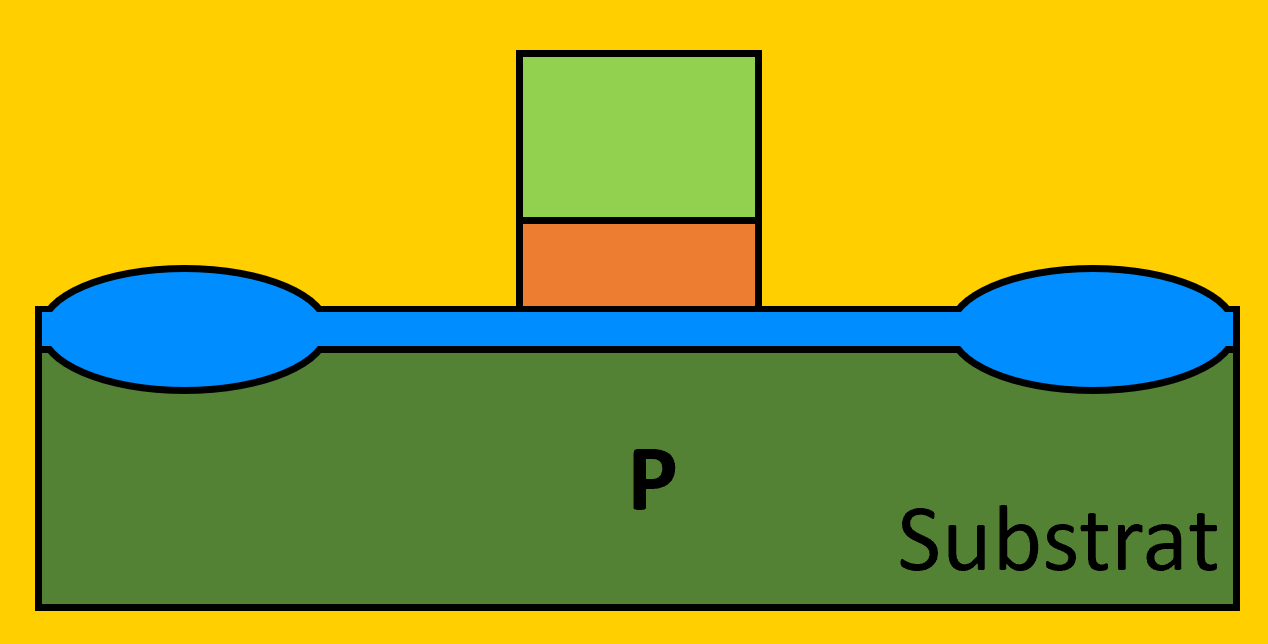
Schritt 12
Nun ist das Polysilizium an den gewünschten Stellen weggeätzt. Daher wird nun der Lack wieder entfernt. Dies geschieht nasschemisch mithilfe einer Entwicklerlösung.
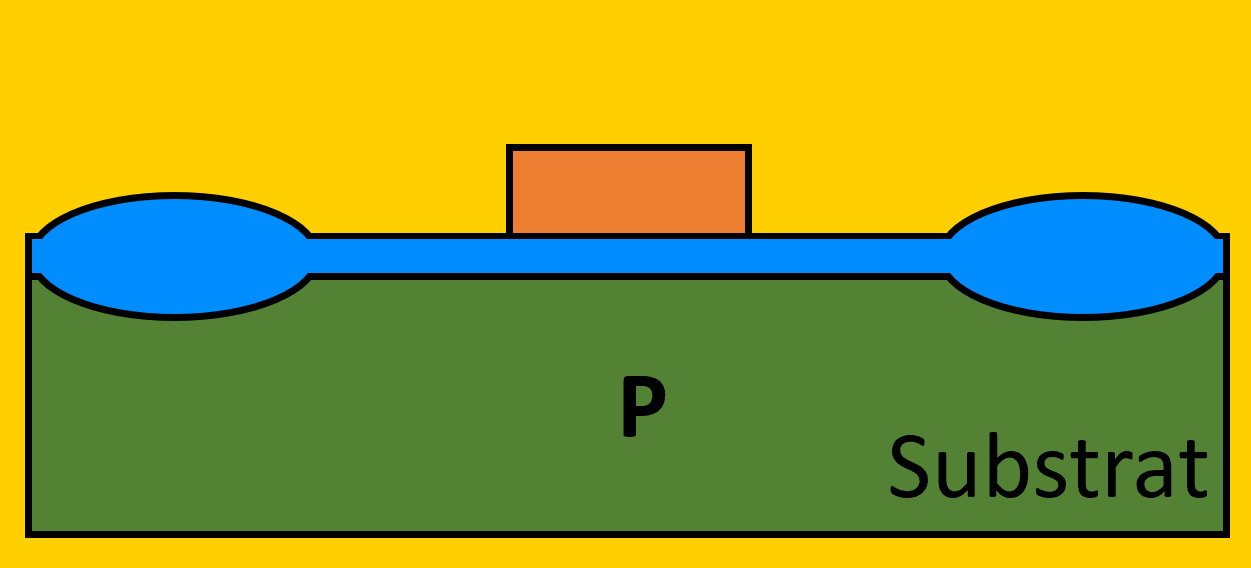
Schritt 13
In diesem Schritt wird ein dünnes Oxid, das sogenannte Postoxid, abgeschieden.
Die Aufgabe des Oxides liegt einerseits im Schutz der Gateelektrode,
anderer Seits dient es als sogenannter Spacer für die Source- bzw. Drainimplantation, zu welcher es später kommt.

Schritt 14
Im folgenden werden die Bekannten Source- und Drain-Gebiete in den Körper impementiert.
Hierzu erfolgt ein Implantationsschritt mit Phosphorionen wodurch das Source- und Drain-Gebiete entsteht bzw. die Gebiete entsprechend n-dotiert werden.
Wie im vorherigen Schritt erwähnt dient die Gateelektrode dabei als Maske. Sie gibt vor wo genau das Source- und das Drain-Gebiet entsteht.
Da so die Weite dieser n-dotierten Gebiete bereits vorgegeben ist, wird dies auch als Selbstjustierung bezeichnet.

Schritt 15
Mithilfe des LPCVD-Prozesses wird erneut ein Oxid abgeschieden.
Dieses dient der Isolation zu den später darüberliegenden Metallisierungsschichten.

Schritt 16
Erneut wird ein Lack aufgebracht welcher als Ätzmaske für den nächsten Schritt dient.
Bei einem isotropen Ätzprozess werden anschließend die Kanten der Kontaktlöcher abgerundet.

Schritt 17
Nun wird geätzt, sodass die n-dotierten Gebiete freigelegt werden.
Bei dem Ätzen handelt es sich um ein anisotropen Ätzprozess.

Schritt 18
Der Lack, welcher seine Aufgabe als Ätzmaske erfüllt hat, wieder entfernt.

Schritt 19
In diesem Schritt wird in einem sogenannten Sputterprozess Aluminium auf den Körper aufgebracht.
Ziel dabei ist es die Kontaktlöcher mit Aluminium zu verbinden.
Das übrige Aluminium wird in den folgenden Schritten entfernt.

Schritt 20
Für das entfernen wird zunächst erneut eine Lackschicht aufgetragen. Dies geschieht an den Stellen an welchen sich die Kontaktlöcher befinden.

Schritt 21
Das wegätzen des Aluminiums erfolgt mit einem sogenannten anisotropen Trockenätzschritt.

Schritt 22
Im letzen Schritt wird der Lack, welcher seine Aufgabe als Ätzmaske erfüllt hat, wieder entfernt.

Ergebnis
Das Ergebnis ist der fertige MOSFET. Dieser Besitzt grundlegend die beiden n-dotierten Bereiche und als Substrat den p-dotierten Bereich.
Alle drei Bereiche sind zudem Kontaktiert.
Detallierte Darstellung:

Vereinfachte Darstellung:
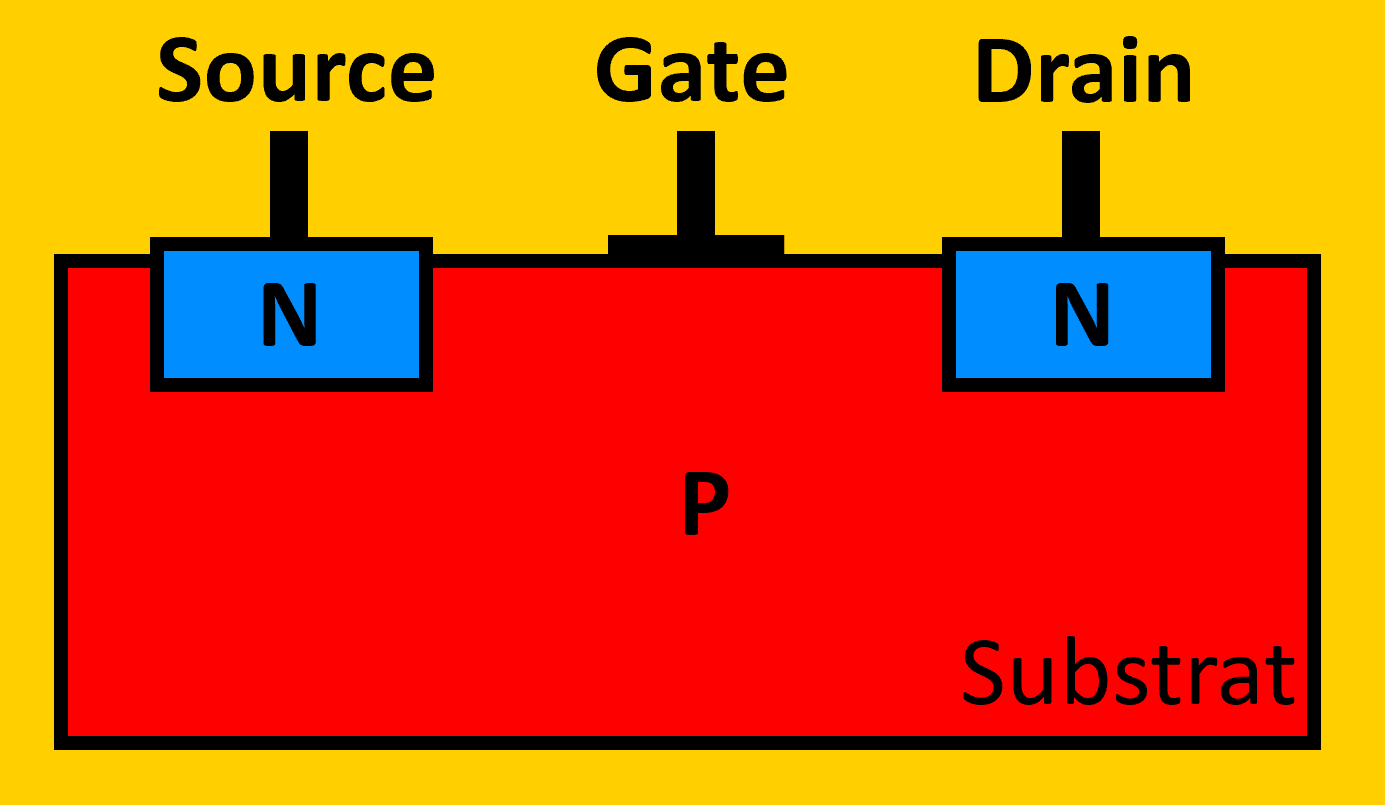
Funktionsweise
Um die genaue Funktionsweise des erstellten MOSFET genauer zu betrachten, dient der folgende Artikel:
⇨ Allgemeine Erklärung